Broadcom a récemment dévoilé sa technologie de plateforme 3.5D XDSiP, axée sur la conception de plateformes informatiques personnalisées, visant des gains importants en termes de performances et d’efficacité.
Technologie Révolutionnaire : La Plateforme 3.5D XDSiP de Broadcom
Dans un communiqué, Broadcom Inc. a annoncé la mise à disposition de sa technologie de plateforme 3.5D eXtreme Dimension System in Package (XDSiP). Celle-ci permet aux clients intellectuels en IA de concevoir des accélérateurs personnalisés de nouvelle génération, les XPUs. Cette innovation intègre plus de 6000 mm² de silicium et jusqu’à 12 stacks de mémoire à bande passante élevée (HBM) dans un seul dispositif, promouvant ainsi un calcul basse consommation et haute efficacité.
Les modèles d’IA générative nécessitent des puissances de calcul colossales, impliquant des clusters allant de 100 000 à un million d’XPUs. Ces XPUs exigent une intégration sophistiquée entre le calcul, la mémoire, et les capacités d’entrées/sorties. Face à l’immensité de ces défis, les méthodes traditionnelles peinent à répondre avec efficacité. L’intégration avancée de systèmes dans un package (SiP) devient donc essentielle pour les XPUs de nouvelle génération.
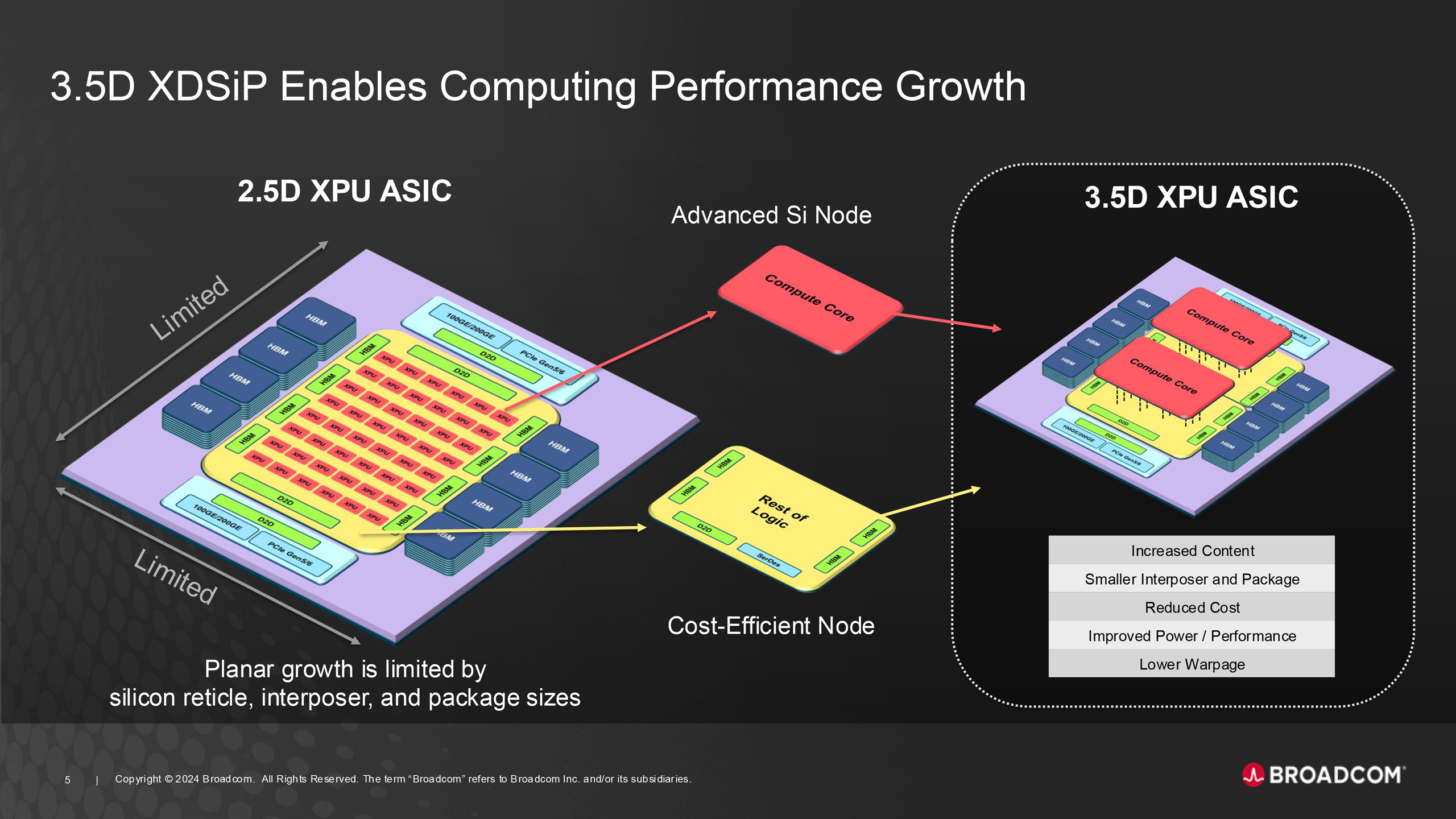
Au cours de la dernière décennie, l’intégration 2.5D, qui combine plusieurs chiplets de 2500 mm² de silicium avec des modules HBM, a prouvé sa valeur pour le développement des XPUs. Cependant, l’émergence de modèles de langage (LLM) de plus en plus complexes exige une empilement de silicium 3D pour optimiser la taille, la puissance et le coût. Ainsi, l’intégration 3.5D, combinant empilement 3D et packaging 2.5D, s’affirme comme la technologie incontournable pour les XPUs à venir.
La plateforme 3.5D XDSiP de Broadcom marque des avancées notables en termes de densité d’interconnexion et d’efficacité énergétique par rapport à l’approche Face-to-Back (F2B). Grâce à l’empilement F2F, les couches métalliques supérieures des puces sont directement interconnectées, offrant une connexion dense et fiable tout en minimisant les interférences électriques.
Avantages Clés de la Technologie 3.5D XDSiP de Broadcom
- Densité d’Interconnexion Améliorée : Permet une augmentation de 7x de la densité des signaux entre les dies empilés.
- Efficacité Énergétique Supérieure : Réduit de 10x la consommation d’énergie dans les interfaces entre dies.
- Latence Réduite : Diminution de la latence entre le calcul, la mémoire et les composants d’entrées/sorties dans l’empilement 3D.
- Format Compact : Favorise des tailles de juxtaposition et packaging plus réduites, entraînant des économies de coûts.
Le XPU F2F 3.5D de Broadcom intègre quatre dies de calcul, un die d’I/O, et six modules HBM. Il s’appuie sur les technologies avancées de processus et de pakaging de TSMC pour garantir un succès en première passe malgré sa complexité.
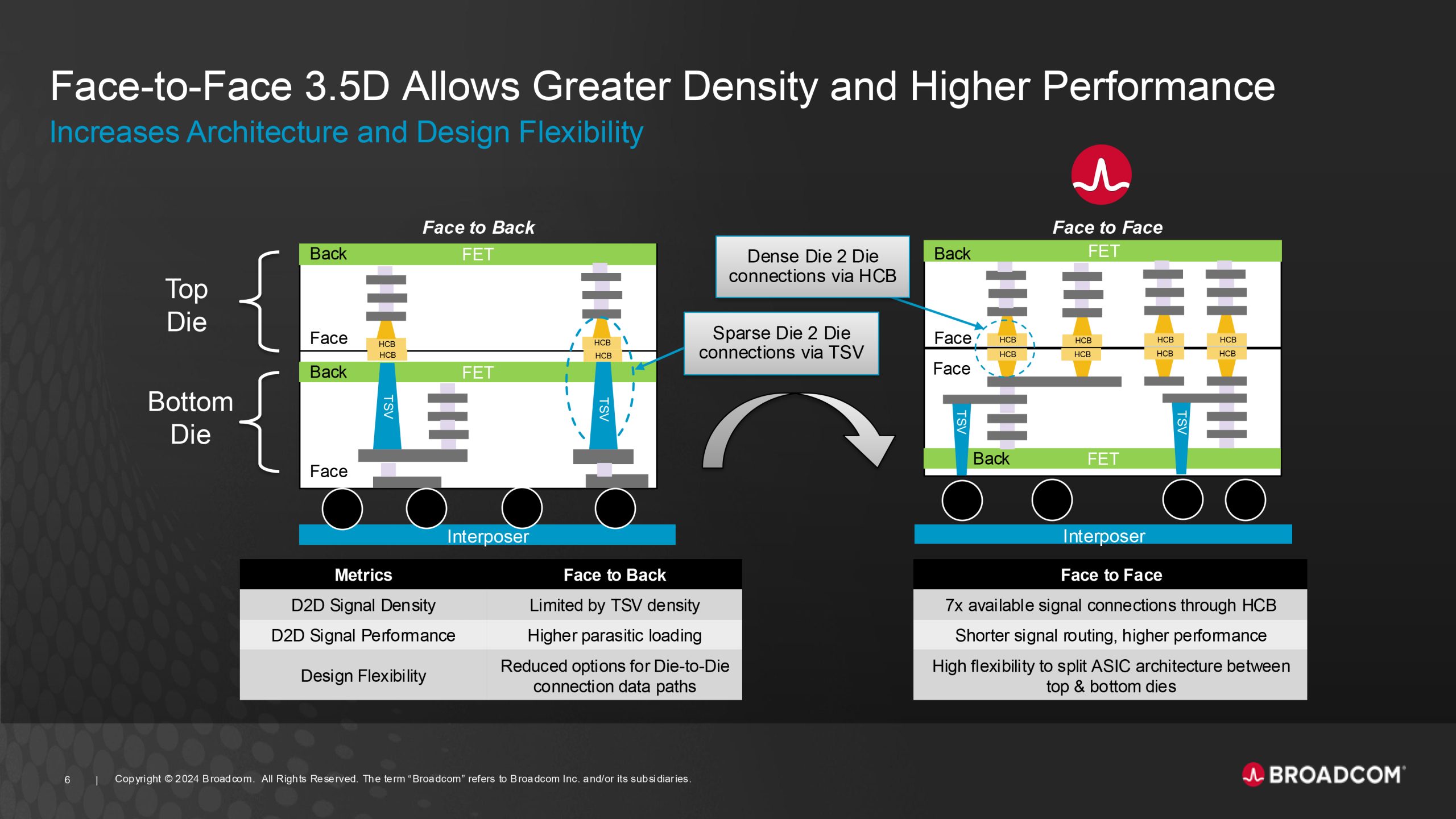
La plateforme 3.5D XDSiP a montré des performances exceptionnelles dans les blocs IP tests, comme les interfaces HBM et les interconnexions entre dies. Ces résultats soulignent l’expertise de Broadcom dans la conception de circuits intégrés complexes.
Les efforts conjoints de TSMC et Broadcom ont permis de marier les technologies de pointe en logique et en empilement de chips. Nous sommes impatients de concrétiser cette plateforme pour stimuler des innovations en IA.
– Dr. Kevin Zhang, SvP du développement des affaires chez TSMC
Avec plus de cinq produits 3.5D en développement, la majorité des clients de Broadcom en IA ont adopté la technologie de la plateforme XDSiP, avec des expéditions de production prévues à partir de février 2026.